
Medições de difração de raios X de alta resolução (HR-XRD) de semicondutores compostos
2023-09-16 10:00XRD de alta resolução (HR-XRD) é um método comum para medir a composição e espessura de semicondutores compostos, como SiGe, AlGaAs, InGaAs, etc.
Quando dopantes ou impurezas são adicionados a umúnico cristalrede de forma deslocada, a rede irá deformar devido à presença de átomos dopantes. Por exemplo, em uma rede de Si, a presença de átomos de Ge causa deformação compressiva porque os átomos de Ge são maiores que os átomos de Si na rede. Esta deformação altera o espaçamento da rede de Si, e esta diferença de espaçamento pode ser detectada por HR-XRD.

Figura 1: Varredura teórica de HR-XRD de uma estrutura geral sob tensão compressiva, como uma camada SiGe de 10 nm em um substrato de Si. Os picos a 0 graus vêm da rede de Si no substrato.
A presença de átomos Ge maiores faz com que os átomos de Si na camada SiGe fiquem mais distantes, fazendo com que o pico de difração se desloque para um ângulo inferior (à esquerda do pico do substrato). Como a camada SiGe de 10 nm é mais fina, o pico de difração da camada SiGe é muito mais largo que o do substrato Si.
Em tais filmes, apenas algumas fileiras de átomos com um determinado arranjo podem ser usadas para produzir um sinal de difração, e oDifração de raios Xo pico é mais largo do que a difração de um substrato de Si, porque existem milhares de linhas no substrato que podem ser usadas para produzir a sequência atômica dos sinais de difração. Se a estrutura estiver sob tensão de tração, os átomos de Si estarão mais espaçados do que os átomos de Si no substrato, e o pico de difração correspondente se moverá para a direita do pico do substrato. Os picos extras no espectro, chamados"listras de espessura,"vêm da interferência aprimorada dos raios X refletidos pela interface entre a camada SiGe e o substrato de Si. Este é o mesmo sinal usado para análise de refletância de raios X (XRR) e pode ser usado para determinar a espessura da camada de deformação.
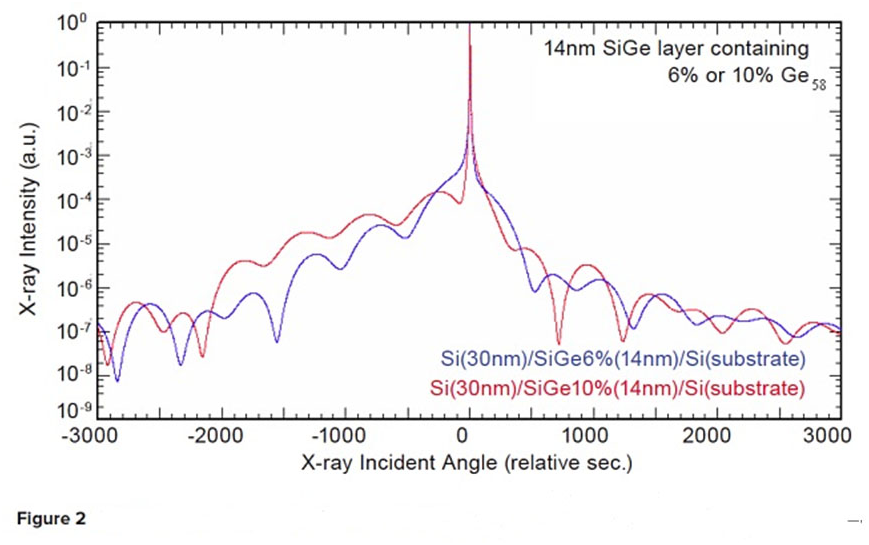
Este método pode ser usado para determinar a composição da camada de deformação. A Figura 2 mostra uma varredura teórica de HR-XRD de duas amostras, cultivadas a partir de um Si de 30 nm em um SiGe de 14 nm em um substrato de Si. No primeiro caso, há 6% de Ge na rede, enquanto no outro caso, há 10% de Ge. O HR-XRD pode facilmente diferenciar essas duas estruturas e determinar a espessura da camada com base na franja de espessura.
Além disso, técnicas avançadas de modelagem permitem descrições precisas de características estruturais, como camadas de SiGe com estruturas graduadas. HR-XRD pode medir uma variedade de materiais epitaxiais, como AlGaAs, InGaAs, InGaN, etc.DRXpode determinar a composição dessas camadas de película fina com uma precisão inferior a 1%. No entanto, deve-se notar que o HR-XRD assume que todos os átomos dopantes estão presentes na rede.
